|
���пƼ������ڽӴ��C���{�Еr��ʾ��Ŀǰ���I���ơ���܇��ӡ��W�jͨ�ŵ��I����Դ����оƬ��Ҫ�Ԃ��y���b����������DIP��BGA��QFP/PFP��SO�ȷ��b��ʽ�����S�����νK������IJ��������������������M���Ӟ�����ĽK�ˌ��Դ�����ķ����ԡ�����Ҫ���оƬ�ߴ�Ҫ����ߣ��Դ����оƬ���b���g��u�Ă��y���b�����M���b�~�M�����w����FC��WLCSP��SiP��3D���b����ʽ��
Ȼ�����S�����νK���Ј�����ij��m���������������M���ӮaƷ����lչ�����Դ����оƬ�ķ����ԡ������Լ��ߴ�����˸��������Ҫ���@��ʹ�Դ����оƬ�ķ��b���g���ò��M�и��£����m���Ј���׃����

�Դ����оƬ����ģ�M�·�������Դ����оƬ�Ĺ����M�з�����Ԍ��䄝�֞�AC/DC�Դ�D�Q����DC/DC�Դ�D�Q�����͉���Է�������LDO����늳ع���оƬ����оƬ����ǰ���Դ����оƬ�ķ��b���g��̎��һ����Ҫ���D���c���Ă��y���b��ʽ��������M�ķ��b���g�^�ɡ��@Щ���ķ��b���g�������bоƬ���b�����A��оƬҎģ���b��WLCSP����ϵ�y�����b��SiP���Լ�3D���b���������H�O��������оƬ�����ܺͷ����ԣ�߀����Ч�ؿs�p�ߴ�ͽ����ķ��������P�I���ã��M����������MƷ�ȽK���Ј����Դ����оƬ�ć��������S�����g���M�������M���b���g�،��ɞ��Դ����оƬ���b�I�������څ�ݡ��M���@Щ���M���b���g�ij��ڳɱ��^�ߣ����S���Ј�Ҏģ�ĔU������a���g�ij��죬�ɱ��AӋ�����͡������@һ�I���Aо��Ƽ��ѽ�ȡ�����Ȱl���ݣ�չ�F�����Ј��I�������Aо���LJ��ȘO�ٔ����ṩ���A�K���졢�yԇ���и���b��������ˇ�ďS��֮һ�����Ŀ��ˇ�C���ˮ���ȫ�����M��оƬ���b���g��
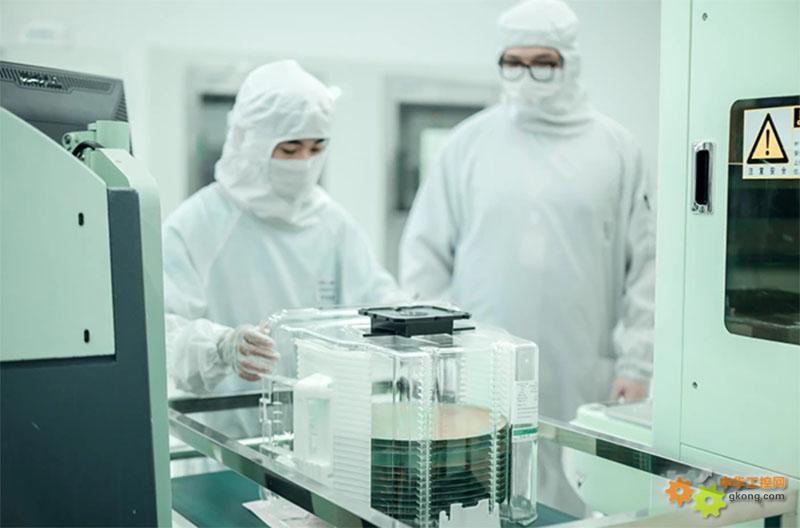
�S��5G�����W�����d���g�Ŀ��ٰlչ�Լ�Ħ��������u�ž�����оƬ���b��Ҫ��Խ��Խ�ߡ��������Aо��Ƽ�����˾�{���������M���b�I������e�ۣ������M���b�I���̽���c���£������I���댧�w�ИI�~���µĸ߶ȡ����M���b���� “��ԽĦ��” ����Ҫ·�������ڰ댧�w���b�Ј��еĝB�ʲ�����ߣ��AӋ�� 2027 �����M���b�Ј�Ҏģ���״γ��^���y���b���_�� 616 �|��Ԫ��ռ�댧�w���b�Ј��ı��������^ 50%��
��Frost&Sullivan�AӋ���Ї��Դ����оƬ�Ԍ��������L�B�ݣ�2021-2026�����L�ʌ��_��7.53%��2026���Ј�Ҏģ�AӋ�� 1284.4 �|Ԫ���ИIҎģ�Ŀ������L������Դ����оƬ��I�İlչ�ṩ���^��İlչ���g�c�C�����ڇ��a���څ���£�����оƬ�OӋ��I�������ü��gҪ���^�ߵ��I��B�����҇����M���b�Ј�Ҏģ�� 2019 ��� 294 �|Ԫ�������L�� 2023 ��� 640 �|Ԫ���ڰ댧�w��y�ИI���w���F���ѵ���r�£����M���b�ИI�Ա����ϝq�����ИO���İlչ�������g�ԡ�
�������M���b��I�ڼ��g�аl�̈́��·��治��ȡ��ͻ�ƣ���u�sС�c���H�I����I�IJ�࣬�Aо��Ƽ�HOTCHIP�ȇ��ȷ�y��I�� 2.5D/3D ���b��ϵ�y�����b�����M���b���g�I���ѽ��߂���һ���ļ��g���������a�����������ڇ����Ј����F��������I�������
|